梁溪區(qū)常見集成電路產(chǎn)品介紹
7、測試儀表內(nèi)阻要大測量集成電路引腳直流電壓時,應(yīng)選用表頭內(nèi)阻大于20KΩ/V的萬用表,否則對某些引腳電壓會有較大的測量誤差。8、要注意功率集成電路的散熱功率集成電路應(yīng)散熱良好,不允許不帶散熱器而處于大功率的狀態(tài)下工作。9、引線要合理如需要加接**元件代替集成電路內(nèi)部已損壞部分,應(yīng)選用小型元器件,且接線要合理以免造成不必要的寄生耦合,尤其是要處理好音頻功放集成電路和前置放大電路之間的接地端。例如:肖特基4輸入與非門CT54S20MDC—符合國家標(biāo)準(zhǔn)T—TTL電路54S20—肖特基雙4輸入與非門M—‐55~125℃D—多層陶瓷雙列直插封裝1、BGA(ball grid array)用集成電路來裝配電子設(shè)備,其裝配密度比晶體管可提高幾十倍至幾千倍,設(shè)備的穩(wěn)定工作時間也可提高。梁溪區(qū)常見集成電路產(chǎn)品介紹
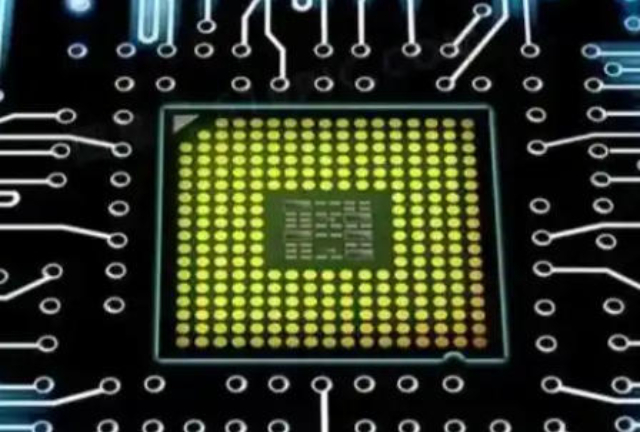
美國Olin公司開發(fā)的一種QFP封裝。基板與封蓋均采用鋁材,用粘合劑密封。在自然空冷條件下可容許2.5W~2.8W的功率。日本新光電氣工業(yè)公司于1993年獲得特許開始生產(chǎn)。31、MSP(mini square package)QFI的別稱(見QFI),在開發(fā)初期多稱為MSP。QFI是日本電子機械工業(yè)會規(guī)定的名稱。34、OPMAC(over molded pad array carrier)模壓樹脂密封凸點陳列載體。美國Motorola公司對模壓樹脂密封BGA采用的名稱(見BGA)。32、P-(plastic)表示塑料封裝的記號。如PDIP表示塑料DIP。33、PAC(pad array carrier)無錫名優(yōu)集成電路市價小引腳中心距QFP。通常指引腳中心距小于0.65mm的QFP(見QFP)。部分導(dǎo)導(dǎo)體廠家采用此名稱。

11、DSO(dual small out-lint)雙側(cè)引腳小外形封裝。SOP的別稱(見SOP)。部分半導(dǎo)體廠家采用此名稱。12、DICP(dual tape carrier package)集成電路雙側(cè)引腳帶載封裝。TCP(帶載封裝)之一。引腳制作在絕緣帶上并從封裝兩側(cè)引出。由于利用的是TAB(自動帶載焊接)技術(shù),封裝外形非常薄。常用于液晶顯示驅(qū)動LSI,但多數(shù)為定制品。另外,0.5mm厚的存儲器LSI簿形封裝正處于開發(fā)階段。在日本,按照EIAJ(日本電子機械工業(yè))會標(biāo)準(zhǔn)規(guī)定,將DICP命名為DTP。
MCM-D是用薄膜技術(shù)形成多層布線,以陶瓷(氧化鋁或氮化鋁)或Si、Al作為基板的組件。布線密謀在三種組件中是比較高的,但成本也高。28、MFP(mini flat package)小形扁平封裝。塑料SOP或SSOP的別稱(見SOP和SSOP)。部分半導(dǎo)體廠家采用的名稱。29、MQFP(metric quad flat package)按照JEDEC(美國聯(lián)合電子設(shè)備委員會)標(biāo)準(zhǔn)對QFP進行的一種分類。指引腳中心距為0.65mm、本體厚度為3.8mm~2.0mm的標(biāo)準(zhǔn)QFP(見QFP)。30、MQUAD(metal quad)集成電路按導(dǎo)電類型可分為雙極型集成電路和單極型集成電路,他們都是數(shù)字集成電路。

42、QFJ(quad flat J-leaded package)四側(cè)J形引腳扁平封裝。表面貼裝封裝之一。引腳從封裝四個側(cè)面引出,向下呈J字形。是日本電子機械工業(yè)會規(guī)定的名稱。引腳中心距1.27mm。材料有塑料和陶瓷兩種。塑料QFJ多數(shù)情況稱為PLCC(見PLCC),用于微機、門陳列、DRAM、ASSP、OTP 等電路。引腳數(shù)從18至84。陶瓷QFJ也稱為CLCC、JLCC(見CLCC)。帶窗口的封裝用于紫外線擦除型EPROM以及帶有EPROM的微機芯片電路。引腳數(shù)從32至84。43、QFN(quad flat non-leaded package)集成電路四側(cè)無引腳扁平封裝。表面貼裝型封裝之一。90年代后期多稱為LCC。QFN是日本電子機械工業(yè)會規(guī)定的名稱。封裝四側(cè)配置有電極觸點,由于無引腳,貼裝占有面積比QFP小,高度比QFP低。無引腳芯片載體。指陶瓷基板的四個側(cè)面只有電極接觸而無引腳的表面貼裝型封裝。梁溪區(qū)本地集成電路工廠直銷
雙列直插式封裝。插裝型封裝之一,引腳從封裝兩側(cè)引出,封裝材料有塑料和陶瓷兩種。梁溪區(qū)常見集成電路產(chǎn)品介紹
26、L-QUAD陶瓷QFP之一。封裝基板用氮化鋁,基導(dǎo)熱率比氧化鋁高7~8倍,具有較好的散熱性。封裝的框架用氧化鋁,芯片用灌封法密封,從而抑制了成本。是為邏輯LSI開發(fā)的一種封裝,在自然空冷條件下可容許W3的功率。現(xiàn)已開發(fā)出了208引腳(0.5mm中心距)和160引腳(0.65mm中心距)的LSI邏輯用封裝,并于1993年10月開始投入批量生產(chǎn)。27、MCM(multi-chip module)多芯片組件。將多塊半導(dǎo)體裸芯片組裝在一塊布線基板上的一種封裝。根據(jù)基板材料可分為MCM-L,MCM-C 和MCM-D三大類。MCM-L是使用通常的玻璃環(huán)氧樹脂多層印刷基板的組件。布線密度不怎么高,成本較低。 MCM-C是用厚膜技術(shù)形成多層布線,以陶瓷(氧化鋁或玻璃陶瓷)作為基板的組件,與使用多層陶瓷基板的厚膜混合IC類似。兩者無明顯差別。布線密度高于MCM-L。梁溪區(qū)常見集成電路產(chǎn)品介紹
無錫大嘉科技有限公司在同行業(yè)領(lǐng)域中,一直處在一個不斷銳意進取,不斷制造創(chuàng)新的市場高度,多年以來致力于發(fā)展富有創(chuàng)新價值理念的產(chǎn)品標(biāo)準(zhǔn),在江蘇省等地區(qū)的汽摩及配件中始終保持良好的商業(yè)口碑,成績讓我們喜悅,但不會讓我們止步,殘酷的市場磨煉了我們堅強不屈的意志,和諧溫馨的工作環(huán)境,富有營養(yǎng)的公司土壤滋養(yǎng)著我們不斷開拓創(chuàng)新,勇于進取的無限潛力,大嘉科技有限公司供應(yīng)攜手大家一起走向共同輝煌的未來,回首過去,我們不會因為取得了一點點成績而沾沾自喜,相反的是面對競爭越來越激烈的市場氛圍,我們更要明確自己的不足,做好迎接新挑戰(zhàn)的準(zhǔn)備,要不畏困難,激流勇進,以一個更嶄新的精神面貌迎接大家,共同走向輝煌回來!
- 惠山區(qū)名優(yōu)汽車連接器市價 2025-12-20
- 梁溪區(qū)常見集成電路產(chǎn)品介紹 2025-12-20
- 錫山區(qū)名優(yōu)汽車連接器廠家現(xiàn)貨 2025-12-20
- 徐州本地集成電路銷售廠家 2025-12-20
- 南京質(zhì)量汽車連接器現(xiàn)貨 2025-12-20
- 江陰名優(yōu)汽車連接器圖片 2025-12-19
- 蘇州名優(yōu)汽車連接器圖片 2025-12-19
- 蘇州質(zhì)量汽車連接器圖片 2025-12-19
- 無錫名優(yōu)汽車連接器生產(chǎn)廠家 2025-12-19
- 錫山區(qū)節(jié)能汽車連接器廠家價格 2025-12-19
- XPZ型切邊帶廠家直供 2025-12-20
- 煙臺警示PVC膠帶代理 2025-12-20
- 蚌埠哪里阻燃材料檢測 2025-12-20
- 深圳摩托車避震器 2025-12-20
- 國產(chǎn)氟素脂批發(fā) 2025-12-20
- 浙江中巴汽車租賃怎么樣 2025-12-20
- 南京不留膠mopp膠帶可模切 2025-12-20
- 江蘇49座汽車租賃大概價格 2025-12-20
- 福建凹凸單板折疊翅片加工 2025-12-20
- 云南商用車主動安全預(yù)警系統(tǒng)技術(shù)解決方案 2025-12-20